一、背景
在電子技術高速迭代的當下,電路性能與可控性已成為產品核心競爭力的關鍵。隨著工業交換機集成度持續提升、工作頻率不斷攀升,其運行過程中產生的熱量顯著增加 —— 這不僅會直接影響內部電路的穩定性與元器件使用壽命,更可能引發系統故障,成為制約設備可靠運行的核心瓶頸。因此,針對交換機 PCB 板的散熱分析與設計,已成為電子工程師在產品研發階段必須攻克的關鍵課題。
二、目的
核心目標是控制產品內部所有電子元器件的工作溫度,確保其在既定工作環境條件下,不超過相關標準及規范規定的最高允許溫度。
最高允許溫度的計算需以元器件應力分析為基礎;溫度閾值需與產品可靠性要求、各元器件分配的失效率指標保持一致。
三、關鍵詞解釋
散熱:指將發熱器件產生的熱量高效發散至環境中的過程,核心技術原理包括熱傳導、熱對流、熱輻射三類,三者常協同作用實現散熱。
熱傳導:熱量從物體高溫部分向低溫部分傳遞,或在接觸的不同物體間傳遞,是固體中熱傳遞的主要形式。例如:工業交換機中 CPU 散熱片底座與芯片直接接觸,將核心熱量導出。
熱對流:液體或氣體中,較熱部分與較冷部分通過循環流動實現溫度均衡的過程,是流體特有的熱傳遞方式。例如:交換機內置散熱風扇帶動腔體內空氣流動,加速熱量散發。
熱輻射:物體通過電磁波(射線)形式向外傳遞熱量,無需依賴介質即可實現,是真空中唯一的熱傳遞方式。例如:交換機金屬外殼通過熱輻射向周圍環境散發熱量。
四、散熱設計方法
散熱設計需遵循 “先明確需求→初步設計→樣機驗證→優化迭代” 的核心流程:先確定發熱器件功率、溫度閾值等核心參數,再在 PCB 設計階段制定初步散熱方案,通過樣機測試驗證方案在散熱效果、使用壽命、成本控制等維度的適配性,達標則方案落地,未達標則重新優化設計。
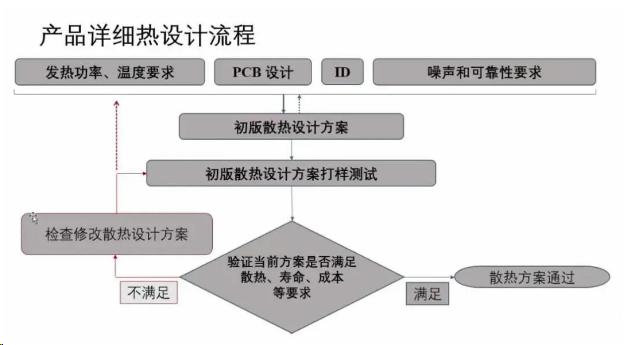
PCB 板層面散熱設計
PCB 板是散熱系統的基礎載體,其設計合理性直接決定散熱效率,核心圍繞 “器件識別、布局優化、PCB 結構升級” 三大方向展開。
1)發熱器件識別
工業交換機的主要發熱器件包括:防反二極管、功率電感、電源芯片及模塊、控制芯片、交換芯片、PHY 芯片、核心控制板、光模塊等,設計前需精準定位各類器件的發熱功率與溫度耐受范圍。
2)器件合理布局(核心原則)
合理布局是規避熱島效應、提升散熱效率的基礎,需遵循以下原則:
①發熱量大的器件(如功率器件、核心處理器)優先布置在散熱條件優越區域(如靠近通風孔、可通過金屬導體連接外殼的位置);
②避免多個高發熱器件集中布置,防止局部溫度過高形成熱島;
③熱敏器件(如電池、電容等)需避開發熱源,或采取防護措施;若必須靠近熱源,應安裝在熱源下方,且器件橫向安裝面與風向保持平行,適配熱對流規律;
④高發熱器件需預留散熱器固定孔位與安裝空間,優先布置在氣流進出口位置;
⑤自然對流場景下,熱流通道需滿足 “短路徑、大橫截面積” 要求;
⑥冷卻氣流流速較低時,器件采用叉排方式排列,增強氣流紊流程度,提升散熱效果;
⑦發熱器件不直接安裝在機殼上時,兩者間距需≥35-40cm,避免熱量傳導至機殼后影響其他部件。
3)PCB 散熱結構優化
①散熱焊盤與開窗設計:針對 DPAK、D2PAK、QFN 等大功耗封裝器件,在其周邊預留散熱孔陣,PCB 正反面適當開窗,便于后續通過額外散熱措施將熱量傳導至金屬板等散熱載體。
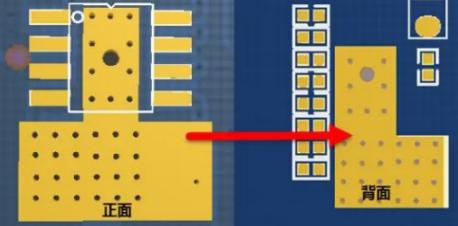
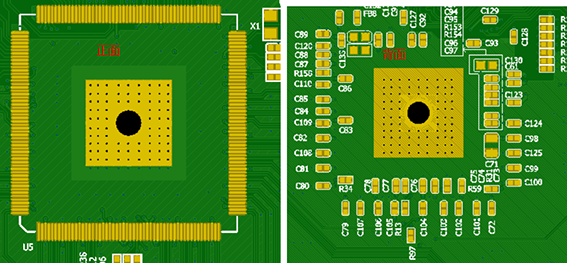
②散熱過孔陣設計:散熱過孔是實現 PCB 層間熱連接、提升縱向導熱能力的關鍵,僅器件焊盤底部及接地管腳周邊的過孔起核心散熱作用。
推薦設計方案:孔徑 10-12mil,孔中心間距 30-40mil,可根據器件熱耗與溫度控制要求調整過孔數量。
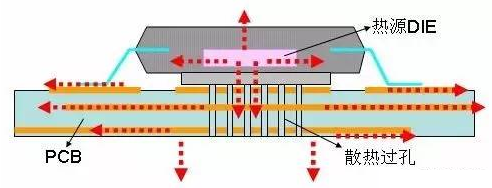
實測數據顯示,增加 4×4 或 6×6 散熱過孔陣后,器件結溫與 PCB 正反面溫度均有顯著下降。

③增大散熱銅箔:通過擴大覆銅面積、增加銅箔厚度(如 2.0oz 銅箔)、增加銅箔層數等方式提升散熱能力。需注意銅箔需保持連續,避免分割影響熱量傳遞效率;鋪銅長度與器件熱阻呈負相關,需根據器件發熱情況確定最小鋪銅尺寸。
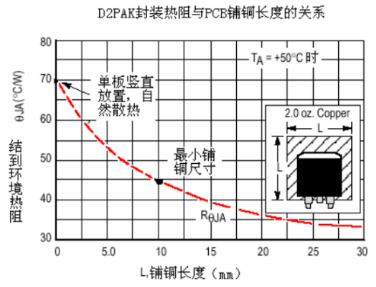
2. 散熱器件選型與設計
1)散熱器件選型評估標準
在環境溫度 T?條件下,用紅外測溫儀測試產品滿載工作 2 小時后所有發熱器件的實際溫度 T?,結合器件結溫 T?、產品最高工作溫度 T?,估算極端工況下器件溫度 T?=(T?+T?-T?)×1.2。若 T?>T?×70% 且 T?>T?,需針對性采取散熱措施。
2)散熱方式設計
①風冷方式選擇:
自然對流:無風扇輔助,適用于多灰塵、室外等不適宜安裝風扇的工業環境;
強制風冷:通過風扇加速氣流流動,散熱效率高、結構簡單、可靠性強,適用于室內控制室等環境優越場景。
②散熱器選型:
a. 常規散熱器:金屬外殼產品優先選擇 “散熱片 + 外殼導熱” 方案;嵌入式產品若 T?<t?×70%<t?
選型計算邏輯:熱阻 R(℃/W)= 溫度差(℃)/ 熱耗(W),需結合硅脂熱阻(通常取 0.1℃/W)綜合計算。
示例:芯片功耗 5W,表面最高允許溫度 125℃,最高環境溫度 75℃,則所需散熱器熱阻 R=(125-75)/5 -0.1=9.9℃/W,按此數值選型。
注意:普通芯片可按 “熱耗≈功率” 估算,電源轉換類芯片 / 模塊因存在能量輸出,不可直接等同,需單獨核算熱耗。
b. 熱管散熱:針對 WiFi6/7、PTP 等大功率交換機,常規散熱方式無法滿足需求時采用。
熱管傳熱能力極強(熱流密度超 200W/cm2),通過工質 “吸熱端蒸發 - 放熱端液化” 循環傳熱,結構緊湊、可靠性高,適用于終端電子設備。

③特殊散熱設計:
雙面散熱:在 PCB 板正反面同時對高發熱器件(如 WiFi + 交換機組合模塊)進行散熱處理。實測顯示,70℃高溫環境下,CPU 溫度可從 115℃降至 97℃,降溫幅度近 20℃;
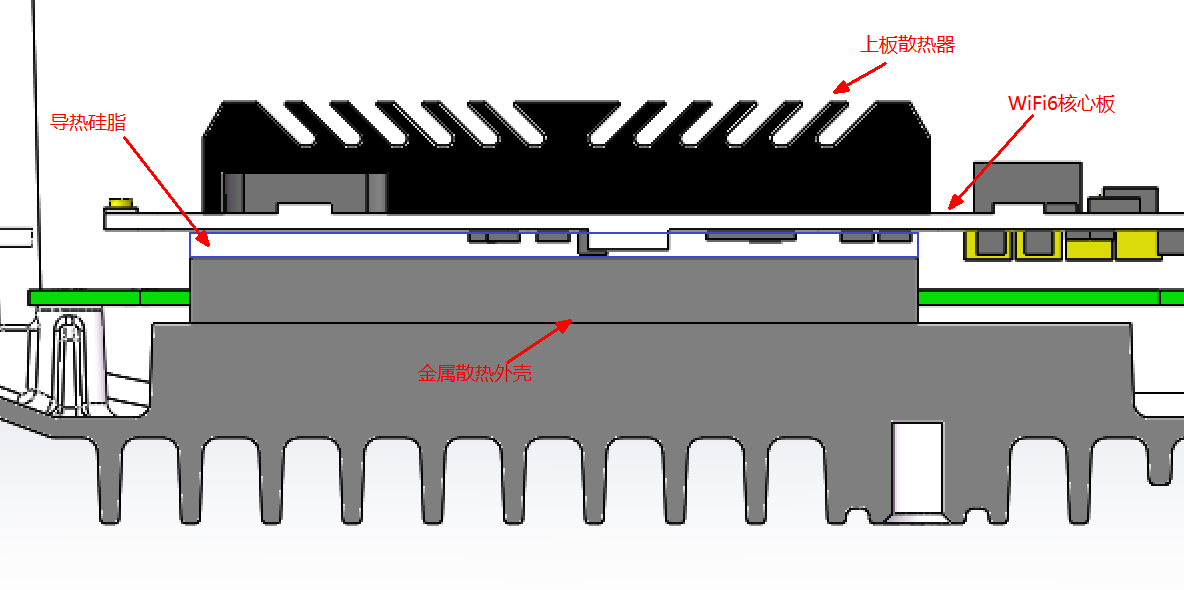
④鋁塊導熱至外殼:
適用于高功耗場景(如總功耗 180W 的 PoE 交換機),通過鋁塊將防反二極管、CPU 等核心發熱器件的熱量傳導至金屬外殼。實測顯示,二極管表面溫度可控制在 101℃(結溫 150℃),WiFi 核心板 CPU 溫度降至 93.7℃(結溫 125℃),符合規范要求。
3. 散熱硅脂片選型
散熱硅脂片的核心參數直接影響導熱效果,需聚焦關鍵指標選型,次要參數(顏色、比重)對散熱效果影響極小,可忽略。

關鍵參數選型標準
①厚度:厚度越小散熱效果越好,散熱器與外殼接觸時需保證厚度≥2mm;計算公式:硅脂片厚度 = L×(1 + 壓縮率)×0.9(L 為散熱器與發熱器件間距)。示例:2mm 間距需選擇 2.25mm 厚硅脂片。
②耐溫范圍:需比發熱器件工作溫度范圍寬 10%。示例:CPU 工作溫度 - 40℃~125℃,硅脂片耐溫范圍需≥-44℃~137℃(低溫可與器件最低溫度一致)。
③體積電阻:需滿足 “體積電阻 / 10mm× 硅脂厚度>1GΩ”,保障絕緣性能。
④耐壓電壓:≥6kV/mm,避免浪涌測試時出現放電現象。
⑤導熱系數:根據器件表面溫度選型 ——>75℃選 5W/(m?k);65℃-75℃選 3W/(m?k);50℃-65℃選 1.5W/(m?k)。
4. 散熱器固定設計
根據散熱器重量、發熱器件功率及接觸面積,選擇適配的固定方式:
①導熱硅膠固定:適用于散熱器輕便、與發熱器件接觸面積大、器件功率小的場景;
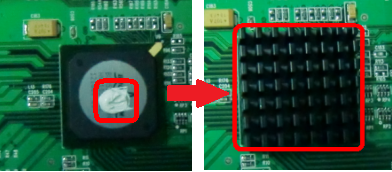
②螺絲 + 散熱鋁塊固定:適用于散熱器較重、散熱面積遠大于發熱器件的場景,需搭配散熱硅膠片增強導熱,通過固定柱與 PCB 板緊固;
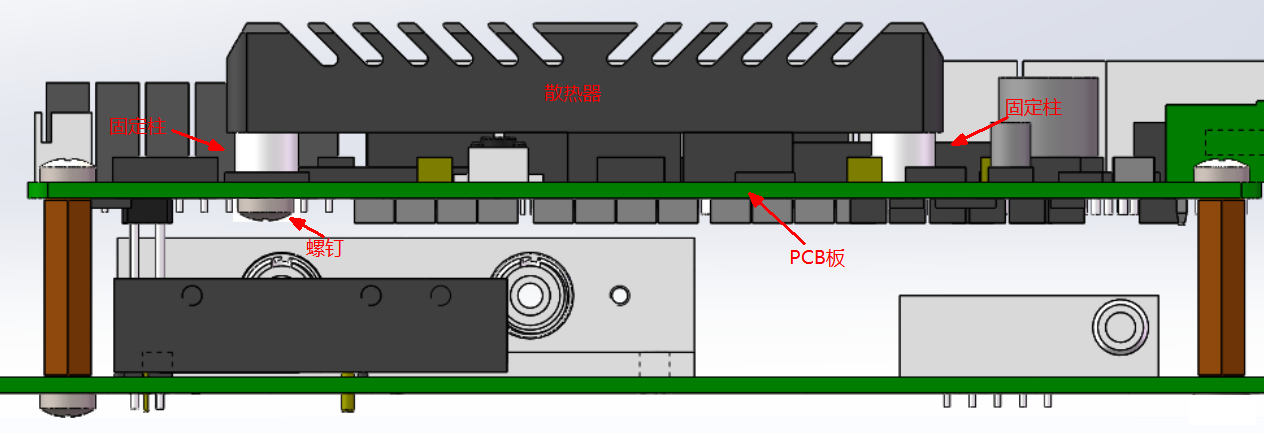
③腳釘彈簧固定:針對重量較大的散熱器,需強化固定穩定性時采用;

④焊針固定:常用于功率二極管、功率 MOS 管等器件;
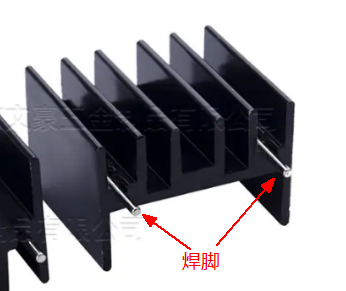
⑤雙面膠固定:適用于器件發熱量小、散熱器輕便的場景。
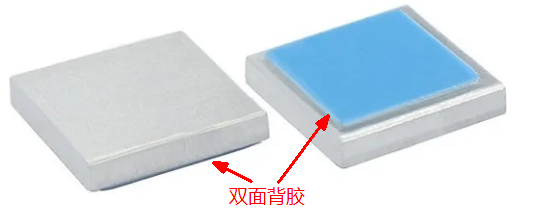
6. 散熱方案驗證
1)采用 “多重測試 + 對比分析” 的方式驗證方案有效性,確保器件溫度達標:
①熱電偶測量:適用于帶外殼產品,測試所有發熱器件表面溫度,需滿足 “<器件結溫 T?×90%”(溫度越低越優);
②紅外熱成像:適用于裸板產品,直觀呈現 PCB 板溫度分布,定位熱點區域;
2)調試口讀取:針對內置溫度傳感器的器件,通過軟件命令讀取芯片內部溫度,與前兩種方法結果對比,取較高值作為評估依據。若測試溫度達標,可進一步優化散熱方式降低成本;若未達標,需重新調整設計方案。
7. 熱仿真分析
熱仿真是設計早期階段的核心分析手段,通過 ANSYS、Flotherm、Cadence Allegro 等專業軟件,在虛擬環境中模擬不同工作條件下電子組件與 PCB 的熱響應,可精準計算溫度分布、熱流及熱阻,快速識別熱點區域。其核心價值在于指導器件布局、材料選型及散熱結構優化,減少物理樣機測試成本,縮短研發周期。
8. 熱隔離設計
當高發熱器件無法分置、且周邊存在熱敏器件時,需采取熱隔離措施 —— 通過隔熱材料(如隔熱鋁板)將發熱器件與熱敏器件隔離,避免熱量傳導影響敏感部件正常工作,類似汽車發動機的隔熱設計邏輯。
五、總結
工業交換機的散熱設計是一項系統性工程,需貫穿研發全流程,核心圍繞 “源頭控熱、路徑導熱、環境散熟” 三大邏輯,整合 PCB 布局優化、散熱材料選型、散熱結構設計、仿真驗證、熱隔離等多重策略。實際應用中,需結合設備工作環境、功率需求、成本預算等具體條件靈活調整方案,實現 “散熱效果、可靠性、經濟性” 的平衡,確保設備在全工況下穩定運行。



